针对部分国产碳化硅MOSFET厂商的闭口不谈的栅氧可靠性隐患,终端用户可通过TDDB(时变介质击穿)和HTGB(高温栅极偏压)实验方法进行检验,反制劣币碳化硅MOSFET供应商的做贼心虚,结合其他可靠性测试手段,筛选出符合要求的器件。小女子业务微信&手机:132 6666 3313,欢迎一起交流,以下是具体检验方法与策略:

测试原理与目的
TDDB测试通过施加高于额定值的电场应力(如30-36V),加速栅氧化层的退化过程,预测其在正常工作条件下的寿命。
栅氧层在长期电场下可能因陷阱电荷积累或局部电场集中导致击穿,TDDB可暴露此类缺陷。
测试步骤与关键参数
加速老化:在高温(如150°C)下施加高电场(如10MV/cm),记录击穿时间,并通过阿伦尼乌斯模型推算寿命。
数据验证:要求供应商提供击穿场强(如接近10MV/cm)和寿命模型,并自主抽样复测以验证数据真实性。
用户策略
重点关注击穿场强分布和韦伯分布参数(如β值),判断工艺一致性。
若供应商仅提供单点测试数据,需要求补充多批次、多电压下的TDDB结果,避免数据片面性。
二、HTGB测试:高温偏压下栅氧稳定性检验测试原理与目的
HTGB模拟器件在高温175°C下长期承受栅极偏压如+22V或-10V的工况,监测阈值电压(Vth)漂移和漏电流变化,评估栅氧层与界面态的稳定性。
正偏压加速电子注入,负偏压加速空穴注入,分别对应Vth的正向或负向漂移。
测试条件与流程
标准条件:温度175°C、偏压+22V(SiC MOSFET典型值)、持续2000小时。
关键步骤:
初始参数记录(Vth、IGSS、RDS(on));
持续监测漏电流,定期(如24小时)复测参数漂移;
判定失效标准:Vth偏移>10%或漏电流超标。
用户策略
要求供应商提供3个批次零失效的测试报告(每批次77个器件),符合AEC-Q101标准。
结合动态参数变化(如Vth漂移曲线)评估退化趋势,避免仅依赖最终数据。
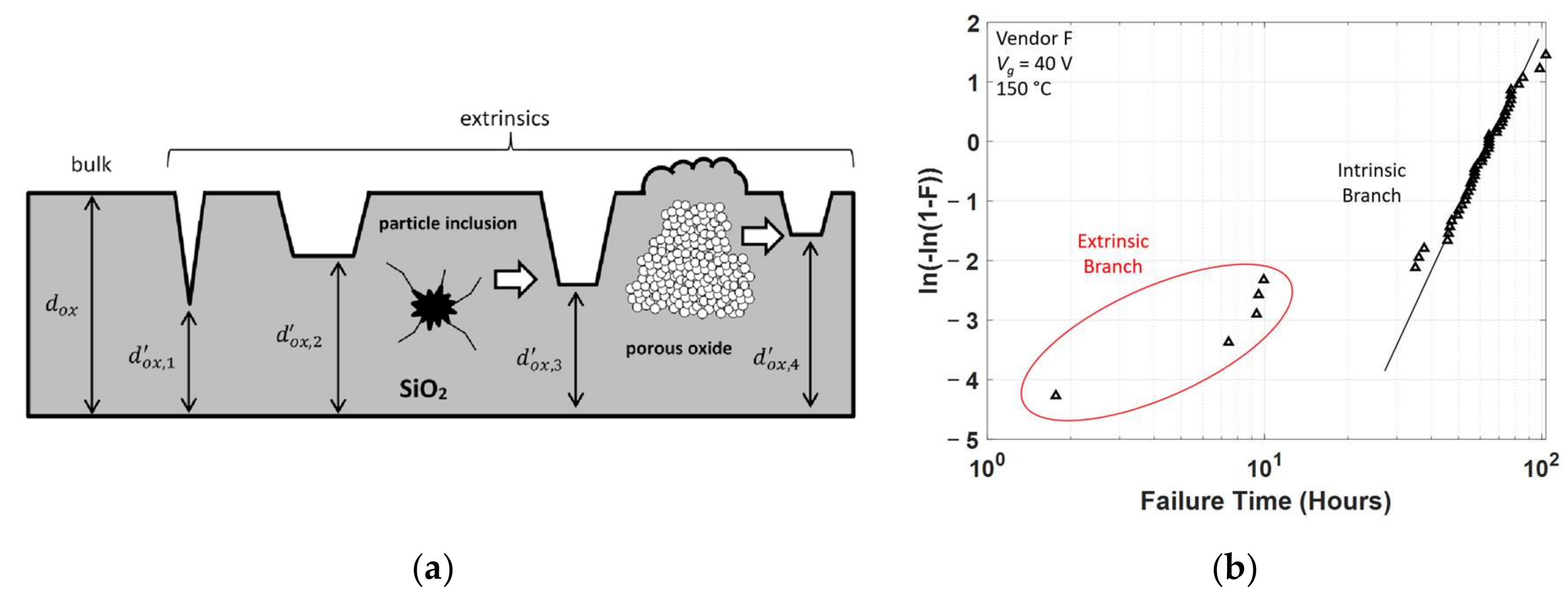
第三方实验室复测
对抽样器件委托独立实验室复测TDDB和HTGB,重点验证击穿时间、Vth漂移等关键参数,防止供应商数据造假。
应用场景模拟测试
搭建实际电路(如高频开关电路),在负载下长期运行并监测参数变化(如RDS(on)增加、开关损耗上升),暴露潜在失效模式。
供应链工艺审核
核查供应商的栅氧生长工艺(如均匀性控制)和钝化层技术。

通过TDDB和HTGB测试,终端用户可系统评估国产碳化硅MOSFET的栅氧可靠性。核心策略包括:
数据验证:要求供应商提供多批次测试报告,并抽样复测;
工艺审核:关注栅氧生长与钝化层技术;
场景适配:根据应用环境(高温、高湿、高频)选择匹配的可靠性测试组合。结合上述方法,可有效规避工艺缺陷风险,确保器件长期稳定运行。
