Die Bound芯片键合,是在封装基板上安装芯片的工艺方法。本文详细介绍一下几种主要的芯片键合的方法和工艺。
什么是芯片键合
在半导体工艺中,“键合”是指将晶圆芯片连接到基板上。连接可分为两种类型,即传统方法和先进方法。传统的方法包括晶片连接(或晶片连接)和电线连接,而先进的方法包括IBM在60年代末开发的倒装芯片连接。倒装芯片键合是一种结合了模具键合和导线键合的方法,是通过在芯片衬垫上形成凸起来连接芯片和衬底的方法。

就像发动机安装在汽车上以提供动力一样,通过将半导体芯片连接在引线框架或印刷电路板(PCB)上,将芯片线路与外部连接起来。芯片连接后,应能承受封装后产生的物理压力,并能散发芯片工作时产生的热量。必要时,它必须保持恒定的导电或实现高水平的绝缘。因此,随着芯片变得越来越小,键合方法变得越来越重要。
芯片键合的流程

传统的芯片键合方法,首先要做的是在封装基板上涂布粘合剂,然后,在上面放一个芯片,芯片有引脚一面朝上。
作为先进封装的倒装芯片键合工艺下,芯片的引脚一面向下,引脚上的焊料球的小凸起附着在芯片的衬垫上。
在这两种方法中,组装后单元通过一个称为温度回流的隧道,该隧道可以随着时间的推移调节温度以熔化粘合剂或焊料球。然后,将其冷却以将芯片(或凸起)固定在基板上。
芯片取放工艺Pick&Place

单独地取出附着在胶带上的芯片被称为“Pick”。当吸嘴从晶圆片中取出芯片,再将它们放置在封装基板表面称为“Place”。这两项动作被称为“拾取和放置”"Piack&Place工艺。这个过程,也可以通过输入晶圆测试结果(Go / No Go)来对好的芯片进行分选。
芯片弹压
每一个完成切片过程的芯片,由弱粘性附着在胶带上。这时,要把水平放置在切丁胶带上的芯片一个接一个地捡起来就不那么容易了。这是因为即使用真空吸尘器拉起它也不容易脱落,如果强行拔出,它会对芯片造成物理损伤。
因此,“弹射”“Ejection"成为一种容易拾取芯片的方法。使用弹射器对目标芯片施加物理力,使其与其他芯片产生轻微的步长差异。将芯片从底部弹出,用真空带柱塞从上面拉起芯片。同时,用真空拉胶带的底部,使薄片平整。

芯片粘合工艺
当使用环氧树脂进行模具粘合时,通过点胶将非常少量的环氧树脂精确地涂在基材上。在其上放置芯片后,环氧树脂通过回流或固化在150至250°C下硬化,以便将芯片和基材粘合在一起。
如果所涂环氧树脂的厚度不恒定,则可能由于热膨胀系数的差异而发生引起弯曲或变形的翘曲。由于这个原因,胶量的控制非常重要。但只要使用环氧树脂,任何形式的翘曲都会发生。
这就是为什么最近使用模贴膜(DAF)的更先进的粘合方法是首选的原因。虽然DAF有一些昂贵和难以处理的缺点,但它的厚度可以很好的控制,并且简化了工艺过程,因此它的使用量逐渐增加。
模贴膜(DAF)粘接
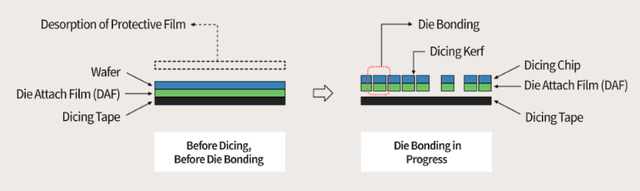
DAF(Die Attach Film)是一种附着在模具底部的薄膜。使用DAF,厚度可以调整到比使用聚合物材料时更薄和恒定。它不仅广泛用于芯片与衬底的键合,还广泛用于芯片与芯片的键合,以创建多芯片封装(MCP)。
从切片芯片的结构来看,位于芯片底部的DAF是托住芯片的,而切片胶带则是牵拉其下方的DAF,附着力较弱。为了在这种结构中进行模具粘合,在一次将芯片和DAF从切丁带上取下后,应将模具放置在基板上,而不使用环氧树脂。这个过程跳过点胶程序,不仅速度更快,而且完美避开了点胶厚度不均引起的问题。
使用DAF时,一些空气可以穿透薄膜,引起薄膜变形等问题。特别是,处理DAF的设备需要高精度。然而,使用daf是首选的方法,因为它可以减少缺缺率,提高生产率,因为它简化了过程,增加了厚度的均匀性。
根据基板类型(引线框架或PCB),进行模键合的方法变化很大。长期以来,基于pcb的基板被频繁使用,因为它可以批量生产小尺寸的封装。随键合技术的多样化,烘烤胶粘剂的温度分布也在不断发展。有代表性的粘接方法有热压缩或超声波粘接。随着封装不断向超薄类型发展,集成程度不断提高,封装技术也在多样化。
